Design av puter og sjablongåpninger for SOT23 (triode smAlle sammen crystal type) komponenter
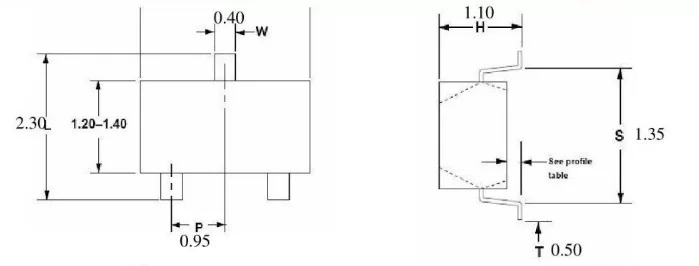
Venstre: SOT23-komponent forfra-størrelse, Høyre: SOT23-komponent fra siden
1. SOT23 loddeskjøt minimumskrav: minimum sidelengde lik pinnebredde.
2. SOT23 loddeskjøt beste krav: Loddeskjøt våter normalt i pinnelengderetningen (avgjørende faktorer: mengde tinn under sjablongen, komponentpinnelengde, pinnebredde, pinnetykkelse og putestørrelse).
3. SOT23 loddeledd maksimumskrav: LoddemetAlle sammen kan stige til, men må ikke berøre komponentkroppen eller halepakken.
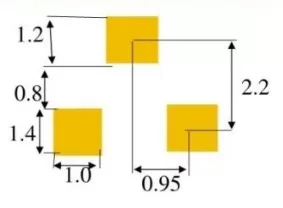
SOT23 pad sjablongdesign
Hovedpunkt: mengden tinn under.
Metode: Sjablongtykkelse 0,12 i henhold til 1:1 hullåpning
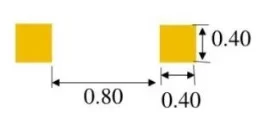
Lignende design er SOD123, SOD123 pads og sjablongåpninger (i henhold til 1:1 åpninger), merk at kroppen ikke kan ta putene, ellers er det lett å forårsake forskyvning av komponenter og flyte høyt.
Vingeformede komponenter (SOP, QFP, etc.) av puten og sjablongdesign
1. Vingeformede komponenter er delt inn i rette vinge og måkevinge, rette vingeformede komponenter i puten og sjablonghullsdesign bør ta hensyn til det interne kuttet for å forhindre loddetinn på komponentkroppen.
2. Vingeformede komponenter loddeforbindelse minimumskrav: minimum sidelengde lik bredden på pinnen.
3. Vingeformede komponenter loddeforbindelser beste krav: loddeforbindelser i retning av lengden på pinnen normal fukting (avgjørende faktorer putestørrelse sjablong under mengden tinn).
4. Vingede komponentloddeforbindelser maksimalt krav: loddetinn kan stige til, men må ikke berøre komponentkroppen eller bakenden.
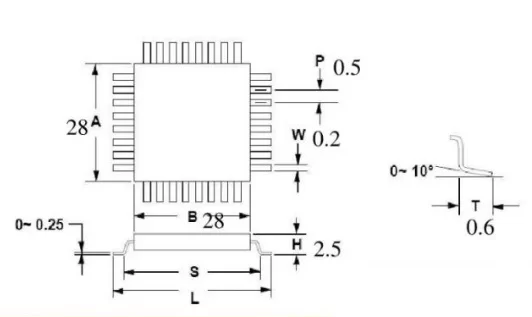
Typisk vingekomponent SQFP208 dimensjonsanalyse
1. AntAlle sammen pinner: 208
2. Pinneavstand: 0,5 mm
3. Benlengde: 1,0
4. Effektiv loddelengde: 0,6
5. Benbredde: 0,2
6. Innvendig avstand: 28

Typisk vingekomponent SQFP208 putedesign: 0,4 mm foran og 0,60 mm bak den effektive blikkenden av komponenten 0,25 mm i bredden.
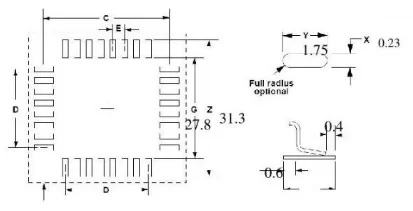
Sjablongdesign for vingekomponent SQFP208: 0,5 mm stigning QFP-vingekomponent, sjablongtykkelse 0,12 mm, lengde åpen 1,75 (pluss 0,15), bredde åpen 0,22 mm, innvendig stigning forblir 27,8 uendret.
Merk: For ikke å kortslutte mellom komponentpinnene, og frontenden av god fukting, bør sjablongåpninger i designet ta hensyn til den interne krympingen og ytterligere, ytterligere bør ikke overstige 0,25, ellers lett å produsere tinnperler, netto tykkelse på 0,12 mm.
Vingeformede komponenter pads og sjablongdesignapplikasjoner
Loddeputedesign: putebredde 0,23 (komponentfotbredde 0,18 mm), lengde 1,2 (komponentfotlengde 0,8 mm).
Sjablongåpning: lengde 1,4, bredde 0,2, masketykkelse 0,12.
Pad og sjablongdesign av komponenter i QFN-klassen
QFN (Quad Flat No Lead) klassekomponenter er en slags pinneløse komponenter, mye brukt innen høyfrekvente, men på grunn av sin sveisestruktur for slottets form og for pinnefri sveising, så det er en viss vanskelighetsgrad i SMT-sveiseprosessen.
Loddefugebredde:
Bredden på loddeforbindelsen skal ikke være mindre enn 50 % av den loddbare enden (avgjørende faktorer: bredden på den loddbare enden av komponenten, bredden på sjablongåpningen).
Loddefugehøyde:
Blancheringspunkthøyde er 25 % av summen av loddetykkelse og komponenthøyde.
Kombinert med selve QFN-klassens komponenter og størrelsen på loddeforbindelseskravene tilsvarer puten og sjablongdesignen følgende:
Poeng: ikke å produsere tinnperler, flytende høy, kortslutning på dette grunnlaget for å øke den sveisbare enden og mengden av tinn under.
Metode: Putens design i henhold til størrelsen på komponenten på den loddbare enden pluss minst 0,15-0,30 mm, (opptil 0,30, ellers er komponenten utsatt for produksjon på tinnhøyden er utilstrekkelig).
Stencil: på grunnlag av puten pluss 0,20 mm, og midten av kjøleribbens broåpninger, for å hindre at komponenter flyter høyt.
BGA ( BAlle sammen Grid Array ) klasse komponentstørrelse
Komponenter i klasse BGA ( BAlle sammen Grid Array ) i utformingen av puten er hovedsakelig basert på diameteren på loddekulen og avstanden::
Etter sveising loddetinn bAlle sammen smelting og loddepasta og kobberfolie for å danne intermetAlle sammeniske forbindelser, på dette tidspunktet diameteren av bAlle sammenen blir mindre, mens smelting av loddepasta i intermolekylære krefter og væskespenning mellom rollen som tilbaketrekning. Derfra er utformingen av puter og sjablonger som følger:
1. Utformingen av puten er generelt mindre enn diameteren på bAlle sammenen 10%-20%.
2. Sjablongåpningen er 10%-20% større enn puten.
Merk: fin pitch, bortsett fra når 0,4 pitch på dette tidspunktet med 100% åpent hull, 0,4 innenfor det generelle 90% åpent hull. For å forhindre kortslutning.
BGA ( BAlle sammen Grid Array ) klasse komponentstørrelse
BAlle sammen diameter | Pitch | Landdiameter | Blenderåpning | Tykkelse |
0.75 | 1.5, 1.27 | 0.55 | 0.70 | 0.15 |
0.60 | 1.0 | 0.45 | 0.55 | 0.15 |
0.50 | 1.0, 0.8 | 0.40 | 0.45 | 0.13 |
0.45 | 1.0, 0.8, 0.75 | 0.35 | 0.40 | 0.12 |
0.40 | 0.8, 0.75, 0.65 | 0.30 | 0.35 | 0.12 |
0.30 | 0.8, 0.75, 0.65, 0.5 | 0.25 | 0.28 | 0.12 |
0.25 | 0.4 | 0.20 | 0.23 | 0.10 |
0.20 | 0.3 | 0.15 | 0.18 | 0.07 |
0.15 | 0.25 | 0.10 | 0.13 | 0.05 |
Sammenligningstabell for komponentblokker i BGA-klassen og sjablongdesign
BGA klasse komponenter i lodding i loddeforbindelsen vises hovedsakelig i hullet, kortslutning og andre problemer. Slike problemer har en rekke faktorer, for eksempel BGA baking, PCB sekundær reflow, etc., lengden på reflow tid, men bare for loddeputen og sjablongdesign bør ta hensyn til følgende punkter:
1. Loddeputedesign bør være oppmerksom på å unngå så mye som mulig gjennomgående hull, nedgravde blindhull og andre hull som kan se ut til å stjele tinnklasse vises på puten.
2. For større stigning bør BGA (mer enn 0,5 mm) være riktig mengde tinn, kan oppnås ved å tykne sjablongen eller utvide hullet, for fin stigning bør BGA (mindre enn 0,4 mm) redusere hullets diameter og sjablongtykkelse.